
・卓上サイズでコンパクト
・局所的なプラズマ加工が可能(φ0.5㎜~)
・低残渣かつ高速加工を実現(10μm/min)
・低出力のRF電源(最大出力50W未満)
・試料をステージで移動させた広範囲の加工が可能

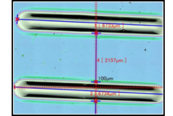

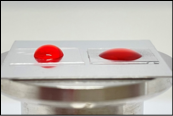
プラズマ発生ノズルからプロセスガスを直接排気する加工方法を吸引プラズマと呼んでいます。
吸引プラズマは、プロセスガスをプラズマ発生ノズルから吹き付ける従来の加工方法に比べ様々な利点があります。
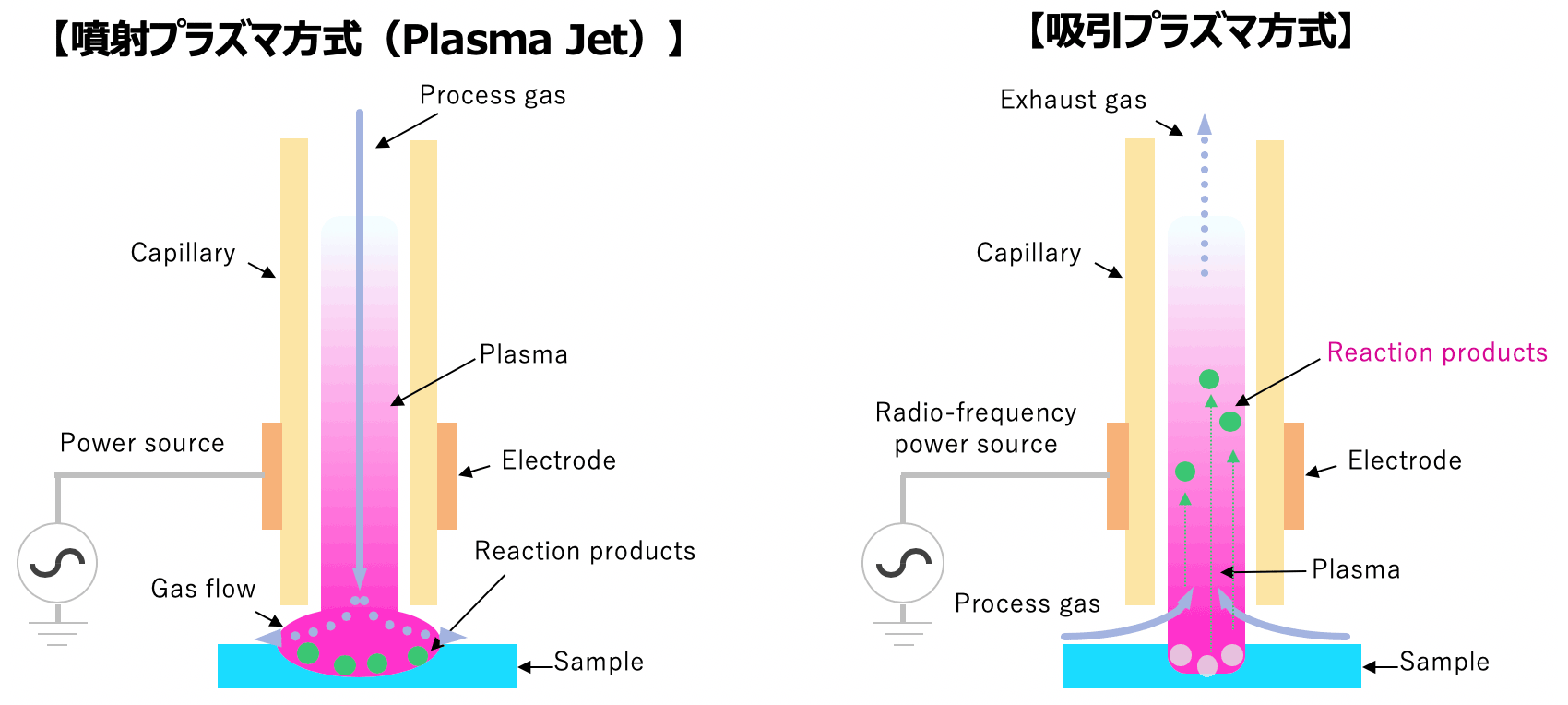
噴出プラズマの場合、プラズマが試料表面に広がる事で加工範囲が広くなります。
しかし、吸引プラズマの場合、プラズマはノズル直下のみに発生する為、より局所的な加工が可能です。
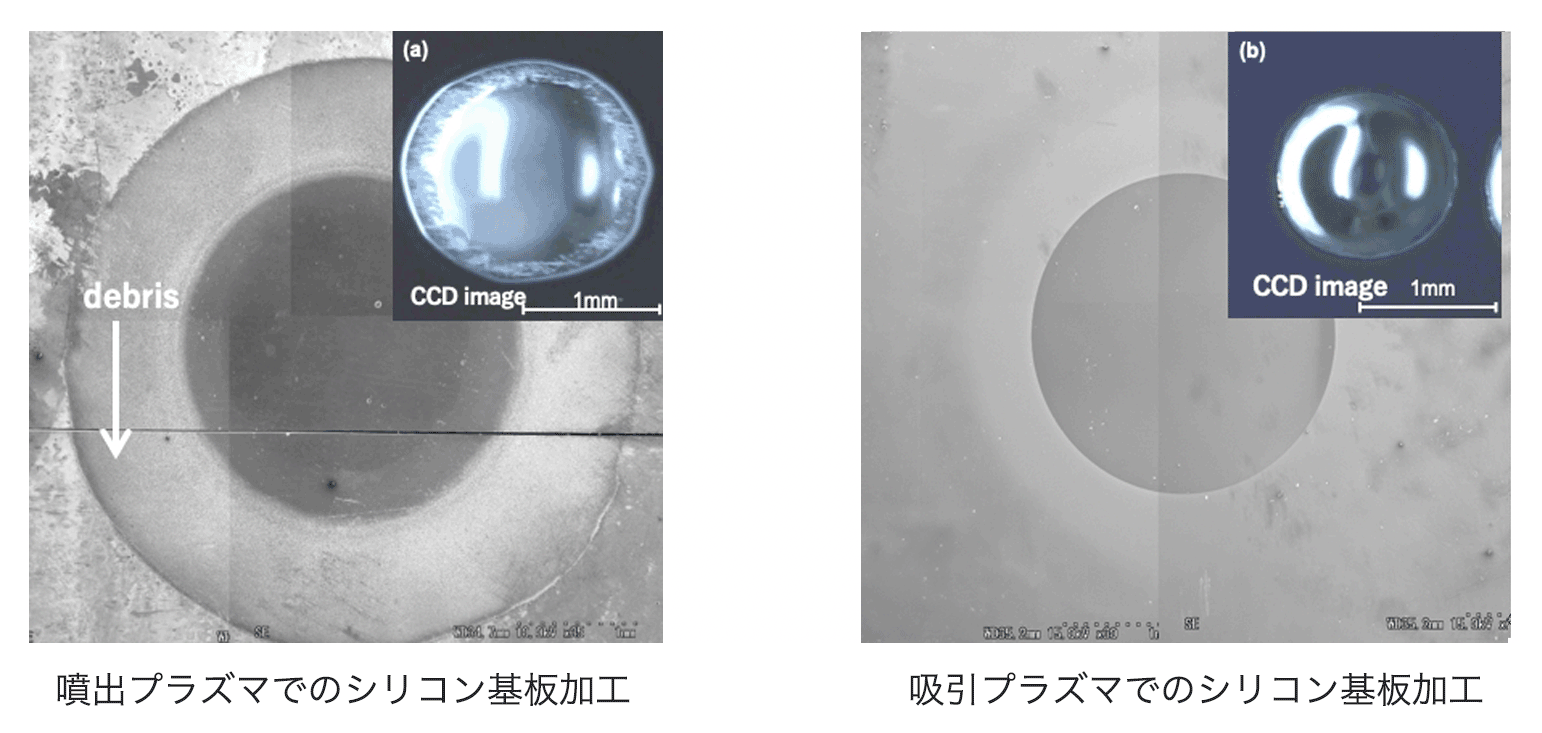
吸引プラズマはエッチングの反応生成物をプラズマ発生ノズルから直接排気する事で残渣の発生を低減することが可能です。
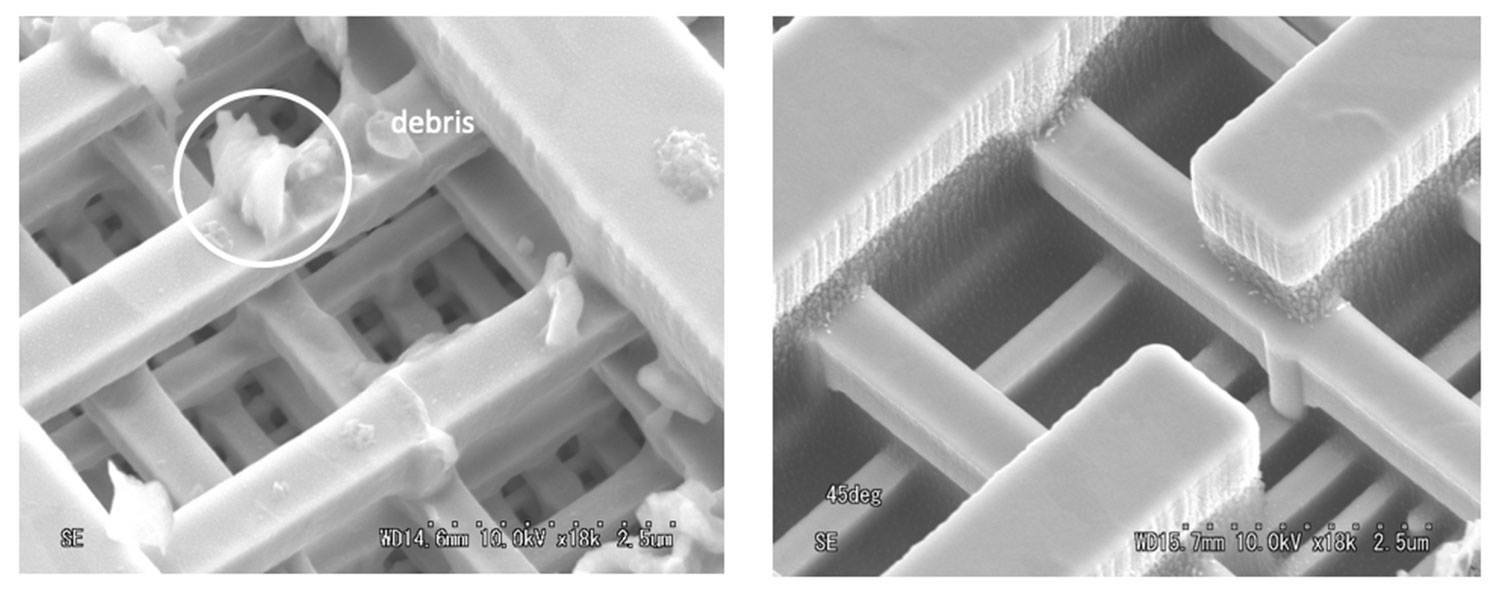
吸引プラズマではプラズマ化した高温のガスを試料に直接吹き付けずに加工する為、加工中の試料温度の上昇を減少する事が可能です。
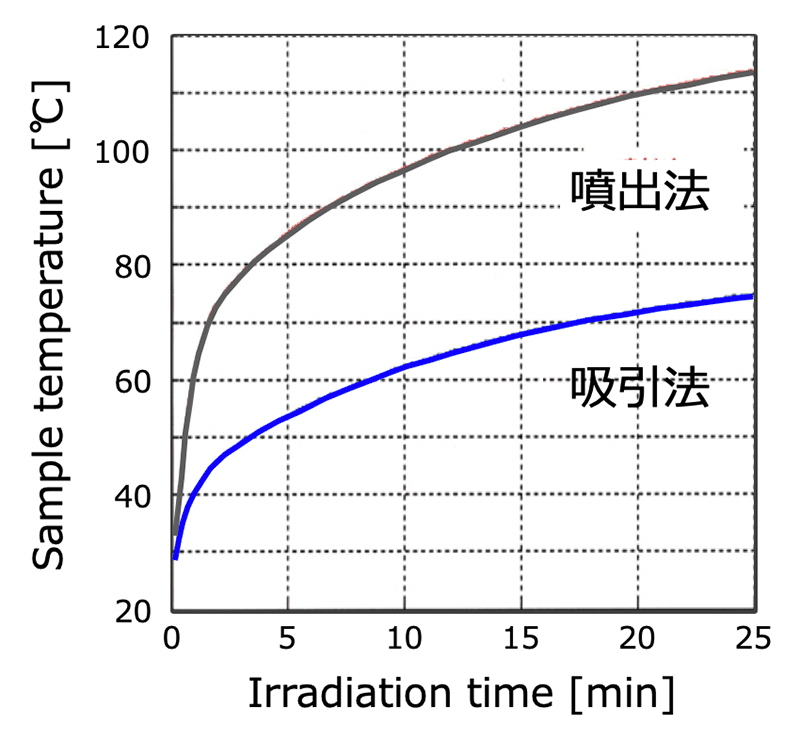
| 型式 | TP-50B |
|---|---|
| 装置寸法 | 装置本体: 240mm(W) × 390mm(D) × 350mm(H) 重量:20 kg |
| ステージ仕様 | 3軸ステージ (Z軸手動、X,Y軸電動ステージ) |
| 搭載試料 | 最大搭載可能サイズ:100mm × 100mm × t10mm |
| 対応可能ガス | N2、D.A、Ar (CF4,O2はオプションとなります) |
| 対象材料 | 有機膜、Si、SiO2、SiN、SiC (エッチングにはCF4ガスが必要となります) |
